Процесс недополнения является обычно используемым процессом в производстве электронного оборудования, его главная роль заключается в заполнении пробела в нижней части электронного продукта для улучшения стабильности и безопасности продукта.
Причина, по которой недополнение необходимо после завершения сварки флип-чипа, заключается в том, что в сборке флип-чипа возникают следующие проблемы:
① Существуют различия в коэффициентах теплового расширения между различными материалами, что приводит к тепловому напряжению;
② может возникнуть деформация изгиба, которая может привести к сбою компонента;
③ чувствительность к сбоям в результате падения, удара или механической вибрации;
④ Под действием статических нагрузок, таких как тепло, генерируемое при работе теплоотвода, это может привести к ухудшению производительности компонента или сбою;
⑤ Для улучшения срока службы компонента в условиях теплового цикла требуется заполнение дна для повышения его надежности.
Шаги процесса подзаполнения чипов
Предварительная подготовка
Выбор клея: выберите подходящий клей для заполнения, обычно на основе эпоксидной смолы, с хорошей жидкостью, прочностью и прочностью. В зависимости от характеристик клея,
может потребоваться его предварительное нагревание или оттаивание, чтобы обеспечить использование в лучшем состоянии.
Проверка оборудования: Подготовьте дозер, отопительное оборудование и другие необходимые инструменты, чтобы обеспечить нормальную работу оборудования. Датчик должен
иметь функцию теплового управления, чтобы сохранить температуру клея стабильной.
Стадия предварительной обработки материнской платы/чипа
Обработка выпечки: запечите материнскую плату или чип, чтобы убедиться, что поверхность сухая, чтобы предотвратить пузырьки при наполнении. Температура и время выпечки зависят от материала и требований.
Операция предварительного нагрева: предварительное нагревание материнской платы или чипа для улучшения жидкости нижнего наполнительного клея для легкого наполнения. Температура предварительного нагрева контролируется при 40 ~ 60 ℃, чтобы избежать повреждения материнской платы или чипа высокой температурой.
Процесс дозирования и наполнения
Операция дозирования: Используйте дозатор для дозирования клея для недополнения в определенном месте на чипе или материнской плате в соответствии с заранее определенным
путём и количеством. При дозировании количество клея, путь, время ожидания и угол и другие параметры должны строго контролироваться, чтобы обеспечить эффект наполнения.
Операция наполнения: с помощью капиллярного эффекта и других методов, дно наполнительного клея естественно диффузируется и заполняет пробел между чипом и субстратом. Избегайте воздушных пузырей во время процесса наполнения, чтобы обеспечить равномерность наполнения и без утечки.
Залечение
Тепловое отверждение: поместите заполненный чип или материнскую плату в отоплительное оборудование, выпечка высокой температуры для ускорения отверждения эпоксидной смолы. Температура отверждения и время зависят от характеристик клея для заполнения нижнего слоя.
Проверка качества: После завершения отверждения эффект наполнения проверяется, чтобы убедиться, что клей заполняется равномерно и без дефектов, таких как пузырьки, переливание или неполное отверждение. Методы инспекции включают в себя разрушительные испытания (например, резание и шлифовка) и неразрушительные испытания (например, рентгеновская инспекция), чтобы убедиться, что эффект наполнения соответствует требованиям конструкции и стандартам качества.
Последующая стадия лечения
Если требуется другая последующая обработка (например, сварка, испытание и т.д.), это должно осуществляться после того, как будет гарантировано, что недостаточно заполненный
клей полностью вытвердился.
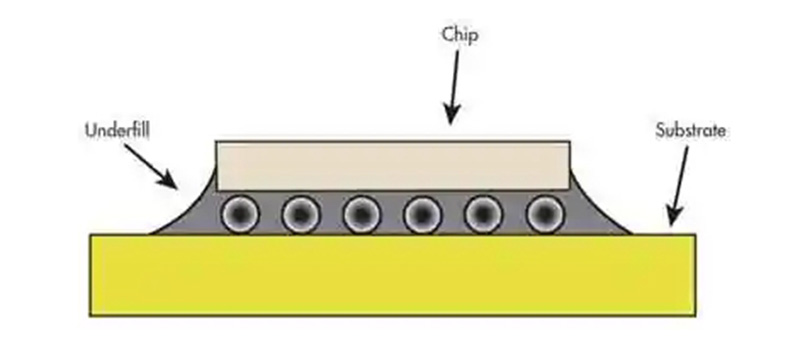
Преимущества процесса underfill:
(1) повышает прочность паевых соединений и, таким образом, продлевает срок службы продукта;
(2) Обеспечить защиту окружающей среды для соединений паек и повысить коррозионную устойчивость продукта;
(3) уменьшить тепловое напряжение между чипом и подложкой и повысить сопротивление тепловому циклу продукта;
(4) Укрепить силу связывания между чипом и подложкой и улучшить сопротивление продукту удару и вибрации.
Недостатки процесса недополнения:
(1) увеличивает стоимость и сложность пакета, требуя вложения дополнительного оборудования и материальных ресурсов;
(2) Материалы и параметры подзаполнения должны быть тщательно выбраны, чтобы обеспечить, что они соответствуют характеристикам чипа и подложки, предотвращая сбои, такие
как остаточное напряжение, трещины, коррозия и пустоты;
(3) После того, как упаковка завершена, ее трудно отремонтировать или переработать, и подзаполнение должно быть удалено, прежде чем можно проверить или заменить соединения
пайки;
(4) Возможно негативно повлиять на электрические свойства чипа, такие как вызывание задержки сигнала, перекрестного разговора, шума и других проблем.
Процесс подзаполнения играет важную роль в изготовлении электронного оборудования, хотя и несет определенные проблемы, но его преимущества очевидны. В практическом
применении необходимо всесторонне рассмотреть преимущества и недостатки процесса и разумно выбрать его использование для обеспечения стабильности и надежности продукта.