Пакет BGA, также известный как пакет ball grid array, представляет собой набор шариков припоя, выполненных в нижней части подложки пакета в качестве конца ввода-вывода схемы для соединения с печатной платой (PCB). Устройство, изготовленное с использованием этой технологии, предназначено для поверхностного монтажа.
Классификация пакетов BGA
1. Пластиковая подложка для ПЛИС (BGA): как правило, это многослойная плата, состоящая из 2-4 слоев органических материалов. В процессорах Intel серии Pentium II, III и IV используется такая форма упаковки. За последние два года появилась еще одна форма: привязка микросхемы непосредственно к доске. Ее цена намного дешевле обычной. Обычно она используется в играх и других областях, где нет строгих требований к качеству.
2. Подложка CBGA (CeramicBGA), то есть керамическая подложка. Для электрического соединения между чипом и подложкой обычно используется метод установки flip-chip (FC). Среди процессоров серии Intel процессоры Pentium I, II и Pentium Pro имеют такую форму упаковки.
3. Подложка FCBGA (FilpChipBGA): жесткая многослойная подложка.
4. Подложка TBGA (TapeBGA): Подложка представляет собой мягкую 1-2-слойную печатную плату в форме полосы.
5. Подложка CDPBGA (Carity Down PBGA): относится к квадратной области вдавленного чипа (также называемой областью полости) в центре упаковки
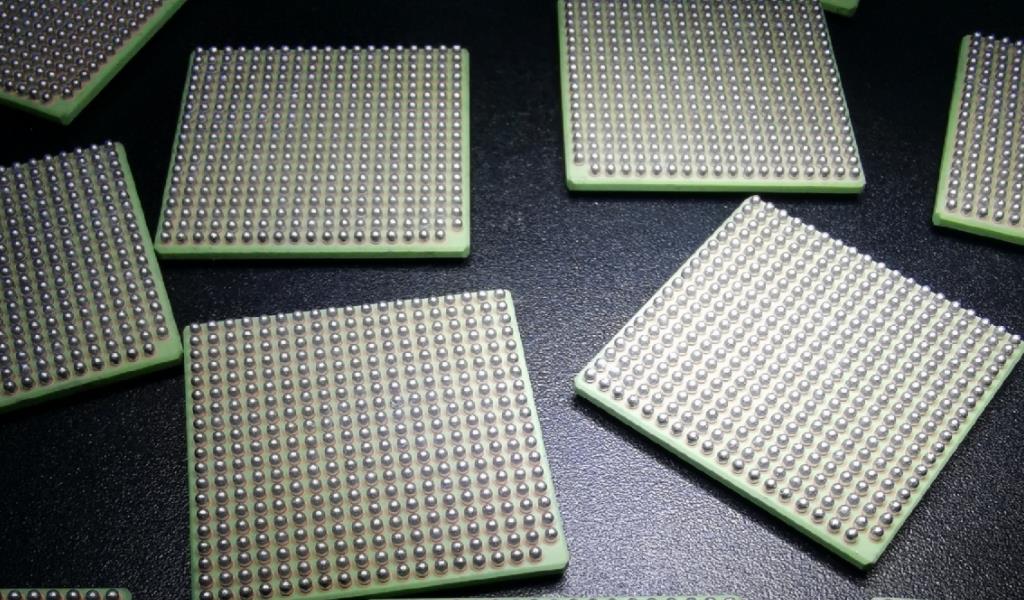
Упаковка BGA
В настоящее время существует множество стилей упаковки микросхем, каждый из которых имеет свои преимущества. Например, наиболее распространенные упаковочные конвейеры включают упаковку BGA, упаковку SOP, упаковку QFN, упаковку PLCC, упаковку SSOP, упаковку QFP и т.д. Итак, сегодня мы расскажем о преимуществах и недостатках BGA-упаковки.
Преимущества BGA-упаковки
1. BGA имеет небольшой размер, но большой объем памяти. Для той же микросхемы памяти с той же емкостью объем BGA составляет всего одну треть от объема SOP-упаковки.
2. Штифты для упаковки QFP и SOP расположены по всему корпусу. Когда штифтов много и расстояние между ними несколько уменьшено, штифты легко деформируются и сгибаются. Однако шарики припоя BGA расположены в нижней части упаковки, и расстояние между ними увеличивается, что значительно повышает выходную мощность.
3. Электрические характеристики хорошие, контакты BGA очень короткие, шарики припоя используются вместо выводов, а пути прохождения сигнала короткие. Уменьшаются индуктивность и емкость выводов и повышаются электрические характеристики.
4. Хорошая теплоотдача. Сферическая контактная матрица и контактная поверхность подложки образуют зазор, что благоприятно сказывается на теплоотдаче корпуса.
5. Корпус BGA и печатная плата имеют хорошую компланарность, что позволяет эффективно обеспечивать качество сварки.
Недостатки упаковки BGA
1. Контроль качества и техническое обслуживание после сварки BGA затруднены. Для обеспечения электрических характеристик сварного соединения необходимо использовать рентгеновский контроль. О качестве контроля нельзя судить невооруженным глазом и с помощью AOI.
2. Контакты BGA расположены в нижней части корпуса, что может легко вызвать эффект затенения при сварке. Поэтому кривая температуры сварки должна быть высокой. Необходимо отслеживать фактическую температуру сварки в режиме реального времени.
3. Если отдельные паяные соединения выводов BGA сварены некачественно, необходимо извлечь всю BGA и снова скрутить, а затем выполнить вторую сварку накладками. Это влияет на скорость прохождения и электрические характеристики.
4. Корпус BGA очень надежен. По сравнению с QFP с шагом 20 мил, в BGA нет контактов, которые можно погнуть или сломать. Сварка получается прочной. Как правило, если вы хотите извлечь упаковку BGA, вы должны использовать станцию для переработки BGA, чтобы извлечь ее при высокой температуре.

Подложка для упаковки BGA
Существует много типов корпусов BGA, и их форма может быть квадратной или прямоугольной. В зависимости от расположения каналов для шариков припоя, их можно разделить на периферийные, расположенные в шахматном порядке и полностью матричные BGA. В зависимости от различных подложек, они в основном делятся на три категории: PBGA (массив пластиковых шариков для припоя PlasticballSddarray), CBGA (массив керамических шариков для припоя ceramicballSddarray), TBGA (массив ленточных шариков для припоя ленточного типа).
Упаковка из ПЛИС (массива пластиковых шариков)
Упаковка PBGA, в которой в качестве основы используется ламинат из смолы BT/стекла, пластик (эпоксидная формовочная смесь) в качестве уплотнительного материала, а шарик припоя представляет собой эвтектический припой 63Sn37Pb или квазиэвтектический припой 62Sn36Pb2Ag (некоторые производители используют бессвинцовый припой), соединяющий шарик припоя с корпусом упаковки не требует использования дополнительного припоя. Некоторые пакеты PBGA имеют полостную структуру, которая делится на два типа: полость, направленная вверх, и полость, направленная вниз. Этот тип ПЛИС с полостью называется BGA с термическим усилением, или сокращенно EBGA, для повышения эффективности рассеивания тепла. Некоторые также называют его CPBGA (cavity plastic ball array).
Преимущества упаковки из ПЛИС заключаются в следующем:
1. Хорошее тепловое согласование с печатной платой (печатная плата - обычно плата FR-4). Коэффициент теплового расширения (CTE) ламината из смолы BT/стекла в структуре PBGA составляет около 14 ppm/℃, а коэффициент теплового расширения печатной платы - около 17 ppm/куб.см. CTE этих двух материалов относительно близок, поэтому тепловое соответствие хорошее.
2. В процессе пайки оплавлением эффект самовыравнивания шарика припоя, то есть поверхностное натяжение расплавленного шарика припоя, может быть использован для достижения требований к выравниванию шарика припоя и подложки.
3. Низкая стоимость.
4. Хорошие электрические характеристики.
Недостатком упаковки из ПЛИС является то, что она чувствительна к влаге и не подходит для упаковки устройств с высокими требованиями к герметичности и надежности.
Упаковка из ПЛИС (керамических шариковых матриц)
Среди упаковочных материалов серии BGA CBGA имеет самую долгую историю. Ее подложка представляет собой многослойную керамику, а металлическая крышка приварена к подложке с помощью герметизирующего припоя для защиты чипа, выводов и контактных площадок. Материалом для шарика припоя является высокотемпературный эвтектический припой 10Sn90Pb, а для соединения шарика припоя с упаковкой требуется низкотемпературный эвтектический припой 63Sn37Pb. Стандартные размеры шариков для припоя составляют 1,5 мм, 1,27 мм и 1,0 мм.
Преимущества упаковки CBGA (Ceramic Ball Array) заключаются в следующем:
1. Он обладает хорошей воздухонепроницаемостью и высокой влагостойкостью, что обеспечивает высокую надежность упакованных компонентов в течение длительного времени.
2. По сравнению с устройствами на основе ПЛИС, электроизоляционные свойства лучше.
3. По сравнению с устройствами на основе ПЛИС, плотность упаковки выше.
4. Эффективность рассеивания тепла выше, чем у структуры на основе ПЛИС.
Недостатками упаковки на основе ПЛИС являются:
1. Из-за большой разницы в коэффициенте теплового расширения (КТР) между керамической подложкой и печатной платой (КТР керамической подложки A1203 составляет около 7 ppm/куб.см, а КТР печатной платы - около 17 ppm/куб.см) тепловое соответствие является неудовлетворительным, что приводит к усталости паяного соединения. основные виды отказов.
2. По сравнению с устройствами на основе PBGA стоимость упаковки высока.
3. Сложнее выровнять шарики припоя по краю упаковки.
CCGA (ceramiccolumnSddarray) керамическая решетчатая матрица столбцов
CCGA - это улучшенная версия CBGA. Разница между ними заключается в том, что CCGA использует паяные стержни диаметром 0,5 мм и высотой 1,25 мм ~ 2,2 мм для замены шариков припоя диаметром 0,87 мм в CBGA для повышения усталостной прочности паяных соединений. Такая столбчатая структура позволяет лучше снизить напряжение сдвига между керамическим носителем и печатной платой, возникающее из-за теплового несоответствия.
TBGA (Ленточно-шариковая матрица)
TBGA представляет собой полостную конструкцию. Существует два типа соединительных трубок между чипом и подложкой в корпусе TBGA: соединение с помощью флип-чипа и соединение с помощью проволоки. Конструкция соединения при пайке с помощью флип-чипа; чип скреплен с помощью многослойной гибкой ленты-носителя; шарики припоя периферийной матрицы, используемые в качестве конца ввода-вывода схемы, установлены под гибкой лентой-носителем; его толстая герметизирующая крышка также служит теплоотводом, а также играет роль в усилении упаковки, так что шарики припоя под гибкой подложкой имеют лучшую компланарность.
Преимущества TBGA заключаются в следующем:
1. Эффективность термического согласования гибкой ленты-носителя упаковки и печатной платы относительно низкая.
2. В процессе пайки оплавлением эффект самовыравнивания шарика припоя может быть использован для достижения требований к выравниванию шарика припоя и подложки путем измерения поверхностного натяжения шарика припоя.
3. Это самый экономичный пакет BGA.
4. Характеристики рассеивания тепла лучше, чем у ПЛИС.
К недостаткам ПЛИС относятся следующие:
1. Чувствительность к влаге.
2. Многоуровневые комбинации различных материалов отрицательно сказываются на надежности.
Подложка для печатной платы с пакетом BGA