Качество упаковки напрямую влияет на производительность самого чипа, а также на дизайн и изготовление подключенной к нему печатной платы. Поэтому технология упаковки имеет решающее значение.
Важным показателем для оценки уровня развития технологии упаковки чипов является отношение площади чипа к площади упаковки. Чем ближе это соотношение к 1, тем лучше.
Основные факторы, которые следует учитывать при упаковке:
• Для повышения эффективности упаковки соотношение площади чипсов к площади упаковки должно быть как можно ближе к 1:1;
• Контакты должны быть как можно короче, чтобы уменьшить задержки, а расстояние между контактами должно быть как можно большим, чтобы избежать помех и повысить производительность;
• Исходя из требований к теплоотдаче, чем тоньше упаковка, тем лучше.

9 Упаковочные технологии
Процесс разработки упаковки был примерно таким: • Структура: TO→ DIP→ PLCC → QFP → BGA → CSP • Материал: металл, керамика → керамическая плитка, пластик → пластиковая пластмасса • Форма штифта: прямой ввод с длинным выводом → монтаж с коротким выводом или без него → шаровой выступ • Способ сборки: сквозной-монтаж в отверстие→ поверхностный монтаж → прямой монтаж
9 Распространенных технологий упаковки компонентов при обработке печатных плат:
1.Упаковка SOP/SOIC: SOP - это аббревиатура от Small Outline Package, что в переводе с английского означает "небольшой контурный пакет". Технология упаковки SOP была успешно разработана компанией Philips в 1968-1969 годах, а затем постепенно получила дальнейшее развитие:
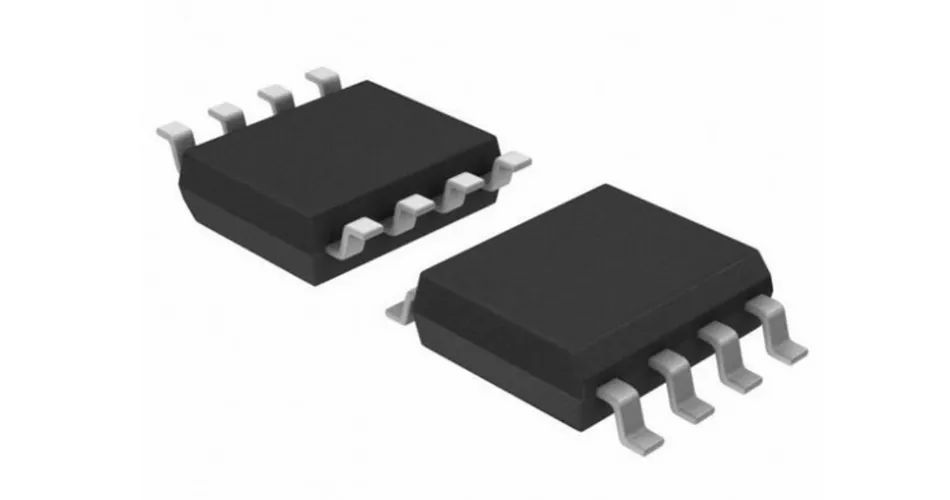
Пакет SOP
l SOJ, J-образный контактный корпус малого размера
l TSOP, тонкий корпус малого размера
l VSOP, очень маленький корпус
l SSOP, уменьшенный SOP
l TSSOP, тонкий уменьшенный SOP
l SOT, транзистор малого размера
l SOIC, интегральная схема малого размера
2. DIP-упаковка: DIP - это аббревиатура от "Double In-line Package" в переводе с английского, то есть двойная встроенная упаковка.

ПОГРУЖНОЙ пакет
Один из комплектов подключаемых модулей, контакты которого выведены с обеих сторон, а упаковочные материалы выполнены из пластика и керамики. DIP - это самый популярный комплект подключаемых модулей, и область его применения включает в себя стандартные логические микросхемы, БИС памяти, микрокомпьютерные схемы и т.д.
3. Упаковка PLCC: PLCC - это аббревиатура от "Plastic Leaded Chip Carrier" в переводе с английского, то есть пластиковая упаковка для свинцовых чипов.

Пакет PLCC
Метод упаковки PLCC, квадратная форма, 32-контактный корпус, все контакты расположены по периметру, намного меньше, чем в DIP-корпусе. Корпус PLCC подходит для монтажа на печатной плате с использованием технологии поверхностного монтажа SMT, благодаря своим преимуществам в виде небольшого размера и высокой надежности.
4. Упаковка TQFP: TQFP - это сокращение от "Thin Quad Flat Package" в переводе с английского, то есть тонкая пластиковая четырехслойная упаковка. Процесс упаковки в четырехслойную упаковку позволяет эффективно использовать пространство, тем самым снижая требования к размеру печатной платы.

Пакет TQFP
Благодаря уменьшению высоты и объема, этот процесс упаковки очень подходит для приложений с высокими требованиями к пространству, таких как PCMCIA-карты и сетевые устройства. Почти все CPLD/FPGA от ALTERA имеют упаковку TQFP.
5. Упаковка PQFP: PQFP - это аббревиатура от "Plastic Quad Flat Package" в переводе с английского, то есть пластиковая четырехъядерная плоская упаковка.

Пакет PQFQ
Расстояние между выводами микросхемы в корпусе PQFP очень мало, а сами выводы очень тонкие. Как правило, в крупных или сверхбольших интегральных схемах используется такая форма упаковки, и количество выводов обычно превышает 100.
6. Упаковка TSOP: TSOP - это аббревиатура от "Thin Small Outline Package" в переводе с английского, то есть тонкая упаковка небольшого размера. Типичной особенностью технологии упаковки памяти TSOP является создание выводов вокруг упакованного чипа. TSOP подходит для монтажа проводки на печатной плате с использованием технологии SMT (поверхностного монтажа).

Пакет TSOP
Форма корпуса TSOP, паразитные параметры (при значительном изменении тока это приводит к нарушению выходного напряжения) снижаются, что делает его пригодным для высокочастотных применений, простым в эксплуатации и надежным.
7. Пакет BGA: BGA - это аббревиатура от "Ball Grid Array Package" в переводе с английского, то есть пакет ball grid array. В 1990-х годах, с развитием технологий, интеграция микросхем продолжала расти, количество выводов ввода-вывода резко возросло, энергопотребление также возросло, а требования к упаковке интегральных схем стали более жесткими. Чтобы удовлетворить потребности разработчиков, в производстве начали использовать BGA-упаковку.

Пакет BGA
Память, упакованная по технологии BGA, позволяет увеличить объем памяти в два-три раза без изменения объема. По сравнению с TSOP, BGA имеет меньший объем, лучшую теплоотдачу и электрические характеристики. Технология упаковки BGA значительно увеличила объем памяти на квадратный дюйм. Объем изделий с памятью, использующих технологию упаковки BGA, составляет лишь треть от объема упаковки TSOP при той же емкости. Кроме того, по сравнению с традиционным методом упаковки TSOP, упаковка BGA обеспечивает более быстрый и эффективный отвод тепла.
Клеммы ввода-вывода в BGA-упаковке распределены под упаковкой в виде круглых или столбчатых паяных соединений в виде массива. Преимущество технологии BGA заключается в том, что, хотя количество выводов ввода-вывода увеличилось, расстояние между выводами не уменьшилось, а увеличилось, что позволило повысить производительность сборки. Несмотря на возросшее энергопотребление, BGA можно сваривать методом контролируемого сжатия стружки, что позволяет улучшить его электротермические характеристики. Толщина и вес упаковки уменьшены по сравнению с предыдущими технологиями.; снижаются паразитные параметры, задержка передачи сигнала невелика, а частота использования значительно увеличивается; для сборки можно использовать копланарную сварку, а надежность высока.
8. Миниатюрная упаковка BGA: Когда речь заходит об упаковке BGA, мы не можем не упомянуть запатентованную компанией Kingmax технологию Tiny BGA. По-английски TinyBGA называется "Крошечная шариковая сетка". Это ответвление технологии упаковки BGA. Соотношение площади чипа к площади упаковки составляет не менее 1:1,14, что позволяет увеличить объем памяти в 2-3 раза без изменения объема. По сравнению с упаковочной продукцией TSOP, она имеет меньший объем, лучшую теплоотдачу и электрические характеристики.

Упаковка TinyBGA
Объем устройств памяти, в которых используется технология упаковки Tiny BGA, составляет всего 1/3 от объема упаковки TSOP при той же емкости. Выводы устройства памяти в упаковке TSOP выводятся с четырех сторон чипа, в то время как выводы TinyBGA выводятся из центра чипа. Этот метод эффективно сокращает дальность передачи сигнала, а длина линии передачи сигнала составляет всего 1/4 от традиционной технологии TSOP, поэтому затухание сигнала также уменьшается. Это не только значительно повышает помехозащищенность чипа и его помехозащищенность от шума, но и улучшает электрические характеристики. Чипы, упакованные в TinyBGA, могут выдерживать внешние частоты до 300 МГц, в то время как традиционная технология упаковки TSOP может выдерживать внешние частоты только до 150 МГц.
Корпус memory of TinyBGA также более тонкий (высота корпуса составляет менее 0,8 мм), а эффективный путь отвода тепла от металлической подложки к радиатору составляет всего 0,36 мм. Таким образом, память TinyBGA обладает более высокой эффективностью теплопроводности, очень подходит для систем, работающих в течение длительного времени, и обладает превосходной стабильностью.
9. Пакет QFP: QFP - это сокращение от "Quad Flat Package", который представляет собой небольшой квадратный плоский пакет. Пакет QFP часто использовался в ранних видеокартах, но мало кто выпускал видеопамять в формате QFP со скоростью более 4 нс. Из-за проблем с процессом и производительностью он был постепенно заменен на TSOP-II и BGA. На упаковке QFP вокруг частиц имеются штифты, которые легко идентифицировать. Плоская упаковка с четырехсторонними штифтами. В одном из комплектов для поверхностного монтажа штифты выведены с четырех сторон в форме крыла чайки (L).

Пакет QFP
существует три типа подложек: керамическая, металлическая и пластиковая. Что касается количества, то подавляющее большинство составляют пластиковые упаковки. Если материал не указан конкретно, то в большинстве случаев это пластик QFP. Пластиковый QFP - это самый популярный многоконтактный модуль LSI, который используется не только для цифровых логических схем LSI, таких как микропроцессоры и вентильные матрицы, но и для аналоговых схем LSI, таких как обработка сигналов VTR и аудиосигнала.
Межосевое расстояние между штифтами имеет множество значений, таких как 1,0 мм, 0,8 мм, 0,65 мм, 0,5 мм, 0,4 мм, 0,3 мм и т.д. Максимальное количество контактов в спецификации с межосевым расстоянием 0,65 мм равно 304.
Выше приведены 9 распространенных технологий упаковки компонентов при обработке печатных плат PCBA, используемых iPCB.