Плата-носитель микросхемы - это подложка, используемая для упаковки голых микросхем.
1. Микросхема, на которой размещен транзистор.
2. Внутри микросхемы есть схемы, обеспечивающие соединение между микросхемой и печатной платой.
3. Защищают, исправляют и поддерживают микросхемы, обеспечивают каналы отвода тепла и являются промежуточными продуктами, обеспечивающими связь между микросхемами и печатными платами.
Рождение платы IC carrier board
В середине 1990-х годов его история насчитывала менее 20 лет. Появились новые интегральные схемы ИС и формы упаковки высокой плотности, представленные шариковыми решетчатыми матрицами BGA, упаковками размером с чип CSP и т.д., что привело к созданию нового необходимого носителя для упаковки - подложки для упаковки ИС.
История разработки транзисторов: электронные лампы → транзисторы → монтаж со сквозными отверстиями → поверхностная упаковка SMT, → упаковка на уровне пластин CSP, BGA, → системная упаковка (SIP)
Печатные платы и транзисторная технология взаимозависимы, тесно взаимосвязаны и тесно скоординированы. Только печатная плата может обеспечить электрическую изоляцию и силовые соединения между различными микросхемами и компонентами, а также обеспечить требуемые характеристики мощности.
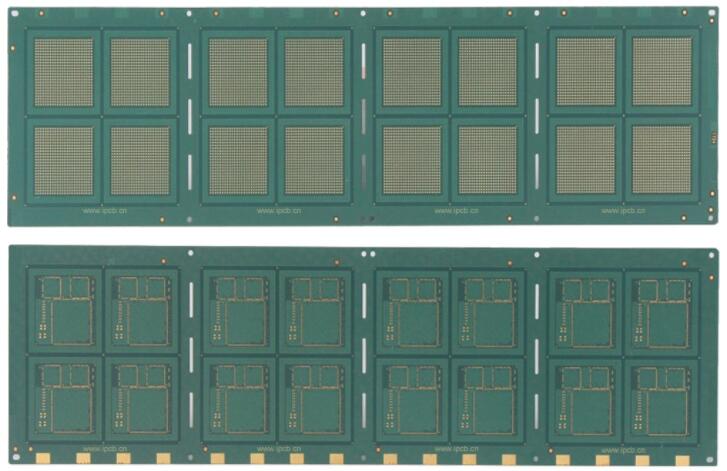
Технические параметры платы-носителя IC
Количество слоев: от 2 до более чем 10 слоев
Толщина пластины: обычно 0,1 ~ 1,5 мм
Минимальный допуск по толщине пластины: 0,05 микрона
Минимальный диаметр отверстия: сквозное отверстие 0,1 мм, микроотверстие 0,03 мм
Минимальная ширина линии: 10~80 микрон
Минимальная ширина кольца: 50 микрон
Допуск по форме: 0~50 микрон
Требуемая технология: заглубленные глухие переходы, импеданс, скрытое сопротивление и емкость
Поверхностное покрытие: Ni/Au, мягкое золото, твердое золото, никель /палладий / золото и т.д.
Размер платы: одна плата-носитель микросхемы ≤240 *90 мм
Плата-носитель микросхем требует большей точности, высокой плотности, большого количества контактов, малого объема, меньшего размера отверстий, дисков и линий, а также ультратонких слоев сердцевины. Поэтому необходимо иметь технологию точного выравнивания слоев, технологию формирования изображений линий, технологию нанесения гальванических покрытий, технологию сверления и технологию обработки поверхности. Ит предъявляет более высокие требования к надежности продукции, оборудованию и инструментам, материалам и управлению производством во всех аспектах. Таким образом, технологический порог для плат-носителей микросхем высок, а исследования и разработки затруднены.
По сравнению с традиционным производством печатных плат необходимо преодолеть технологические трудности, связанные с изготовлением плат-носителей микросхем:
1. Технология производства платы-сердечника: Плата-сердечник тонкая и легко деформируется, особенно если толщина платы составляет ≤0,2 мм. Для достижения сверхтонкого эффективного контроля коробления сердцевинной плиты и толщины ламинирования необходимы такие технологические новшества, как структура панелей, расширение и сжатие плит, параметры ламинирования и система позиционирования промежуточных слоев.
2. Технология микроотверстий: процесс равномерного открывания окон, процесс лазерного сверления микроотверстий с глухими отверстиями, процесс меднения глухих отверстий и процесс заполнения отверстий.
2.1 Процесс создания конформных окон, Conformalmask, является разумной компенсацией за создание лазерных окон с глухими отверстиями. Диаметр и положение глухого отверстия определяются непосредственно через открытое медное окошко.
2.2 Параметры, связанные с лазерным сверлением микроотверстий: форма отверстия, соотношение верхней и нижней апертур, боковая эрозия, выступ стекловолокна, остатки клея на дне отверстия и т.д.
2.3 Меднение глухих отверстий включает в себя: способность заполнять отверстия, наличие пустот в глухих отверстиях, вмятин, надежность меднения и т.д.
В настоящее время диаметр микропор составляет от 50 до 100 микрон, а количество расположенных друг над другом слоев пор достигает 3, 4 и 5 уровней.
3. Технология формирования рисунка и нанесения медного покрытия
3.1 Технология и контроль компенсации линий; Технология изготовления тонких линий; Технология контроля равномерности толщины медного покрытия; Технология контроля микротравления тонких линий.
3.2 В настоящее время требования к ширине линий и расстояниям между ними составляют 20~50 микрон. Требование к равномерности толщины меднения составляет 18 микрон, а равномерность травления - ≥90%.
4. Технология паяных масок включает в себя технологию штекерных отверстий, технологию печати паяных масок и т.д.
Разница в высоте поверхности паяльной маски на плате-носителе микросхемы составляет менее 10 микрон, а разница в высоте поверхности между паяльной маской и подложкой составляет не более 15 микрон.
5. Технология обработки поверхности
Равномерность толщины никелевого/золотого покрытия; процесс нанесения как мягкого, так и твердого золота на одну и ту же пластину; технология нанесения никелевого/палладиевого/золотого покрытия. Линейное покрытие поверхности, технология селективной обработки поверхности.
6. Возможности обнаружения и технология тестирования надежности продукции
6.1 Необходимо оснастить партию испытательного оборудования/приборов, отличных от традиционных заводов по производству печатных плат.
6.2 Освоить технологию тестирования надежности, отличную от традиционной.
7. В совокупности при производстве плат-носителей микросхем задействовано более десяти технологических аспектов:
Компенсация смещения графики
Процесс нанесения рисунка для обеспечения равномерности толщины медного покрытия
Управление расширением и сжатием данных в ходе всего процесса
Процесс обработки поверхности, выборочное нанесение мягкого золота и твердого золота с твердым покрытием, технология нанесения никелевого/палладиевого/золотого покрытия
Производство листов картона с сердечником
Высоконадежная технология обнаружения микроотверстий
Если 3-й, 4-й и 5-й заказы собраны в стопку, производственный процесс
Многократное ламинирование, ламинирование, ламинирование ≥ 4 раз, сверление ≥ 5 раз, нанесение покрытия ≥ 5 раз.
Нанесение рисунка проволокой и травление
Высокоточная система выравнивания
Процесс заделки паяльной маски, процесс заполнения микроотверстий гальваническим покрытием
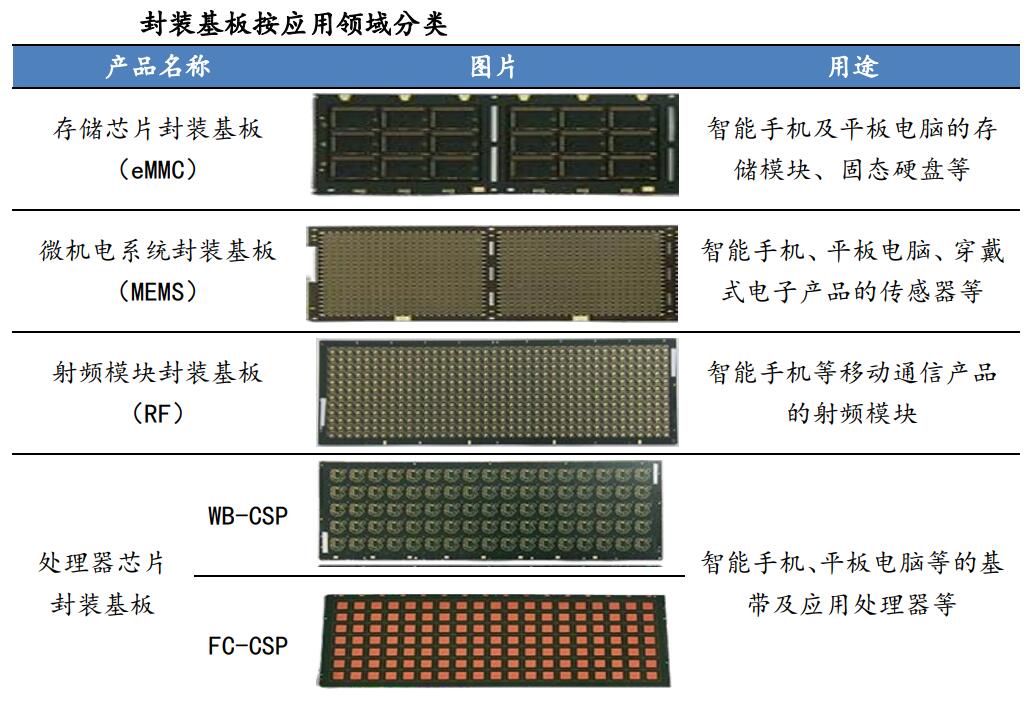
Классификация платы носителя микросхем
Отличается формой упаковки
1. Плата-носитель BGA
BallGridAiry - это английское сокращение от BGA, ball array package, пакет с шариковой решеткой.
Платы такого типа обладают хорошими теплоотдающими и электрическими характеристиками, а также могут содержать большое количество выводов микросхемы и используются в микросхемах с числом выводов 300 и более.
2. Плата-носитель CSP.
CSP - это аббревиатура от chipscale packaging, упаковки на уровне пластин.
Это легкий и компактный однокристальный модуль. Размер его корпуса почти такой же или немного больше, чем размер самой микросхемы. Он используется в устройствах памяти, средствах связи и электронных изделиях с низким количеством контактов.
3. Плата-носитель с откидной крышкой
Его английское название - FlipChipFC, что представляет собой форму упаковки, в которой лицевая сторона чипа переворачивается и непосредственно соединяется с несущей платой выступами.
Преимущества этого типа несущей платы заключаются в низком уровне помех, низких потерях в соединительной цепи, хороших электрических характеристиках и эффективном отводе тепла.
4. Многокристальный модуль
По-английски это Multi-ChipMCM, а по-китайски - многоядерный чип-модуль. Поместите несколько микросхем с различными функциями в один корпус.
Это лучшее решение для того, чтобы электронные изделия стали легкими, тонкими, короткими, меньше, чем высокоскоростные и беспроводные. Используется в высокопроизводительных больших компьютерах или электронных изделиях со специальной производительностью.
Поскольку в одном корпусе находится несколько микросхем, в настоящее время не существует более совершенных решений для устранения помех в сигнале, рассеивания тепла, создания тонких схем и т.д. Этот продукт находится в стадии активной разработки.
Классификация по материалу подложки для IC-картона
1. Подложка для упаковки из твердого картона
Жесткая органическая подложка для упаковки, изготовленная из эпоксидной смолы, BT-смолы и ABF-смолы. На ее долю приходится большая часть материалов для упаковки IC. Коэффициент теплового расширения CTE составляет 13~ 17 ppm/ ℃.
2. Картонная основа для упаковки из мягкого картона
Подложка для упаковки представляет собой гибкий базовый материал, изготовленный из полиимида PI, полиэфирного полиэтилена PE и смолы, с коэффициентом теплового расширения CTE от 13 до 27 ppm/℃.
3. Керамическая подложка
Подложки для упаковки изготовлены из керамических материалов, таких как оксид алюминия, нитрид алюминия и карбид кремния. CTE очень мал, 6~ 8 ppm / ℃.
Различается по технологии connected
1. Проводное соединение платы-носителя
Золотые провода соединяют микросхему с платой-носителем.
2. Плата для крепления вкладок
ВКЛАДКА - устройство для автоматической обвязки лентами, для автоматической обвязки лент и рулонов и для производства упаковки.
Внутренние контакты чипа соединены с чипом, а внешние контакты соединены с упаковочной доской.
3. Переверните плату-носитель для склеивания микросхем
При установке микросхемы переверните лицевую сторону микросхемы, а затем непосредственно подсоедините ее к плате-носителю в виде выступа.